隨著“中國制造2025”的持續推動,中國半導體行業對國產激光切割技術有著更高的要求,推動其朝著高效率、高精度、高質量方向發展。
大族半導體憑借豐富的行業工藝經驗,不斷探索激光切割應用方案,隨著核心技術的提升及客戶需求多元化,迭代推出最新DA100激光切割系統(以下簡稱DA100)。
DA100是基于Ablation工藝原理進行晶圓切割分離的系統,可對晶圓進行表切(切深≤20μm,切寬可定制),半切(切深≤ 100μm,切寬≤20μm),全切(切深≤200μm,切寬≤30μm)三種分離制程,該系統有如下主要特點:
? 從源頭及加工過程中良好地抑制粉塵、熱影響、回熔、崩邊等對晶圓品質造成影響的不利因素,極大提升產品的良品率。
? 進一步提升加工能力,相較于傳統切割能力,可應對200μm厚度以內的晶圓產品(不同材質切割效果會存在差異)。
? 可選多達5套光路系統方案,應對不同材料的分離工藝。
![]() 設備參數
設備參數

![]() 切割原理
切割原理
激光加工原理:利用激光與材料相互作用產生的物理現象,包括熱學效應與力學效應進行加工。隨著激光功率密度的增加,材料分別經歷加熱、熔化、汽化過程。

![]() 工藝流程
工藝流程
支持高精度正背切功能,可應對厚度更大產品。
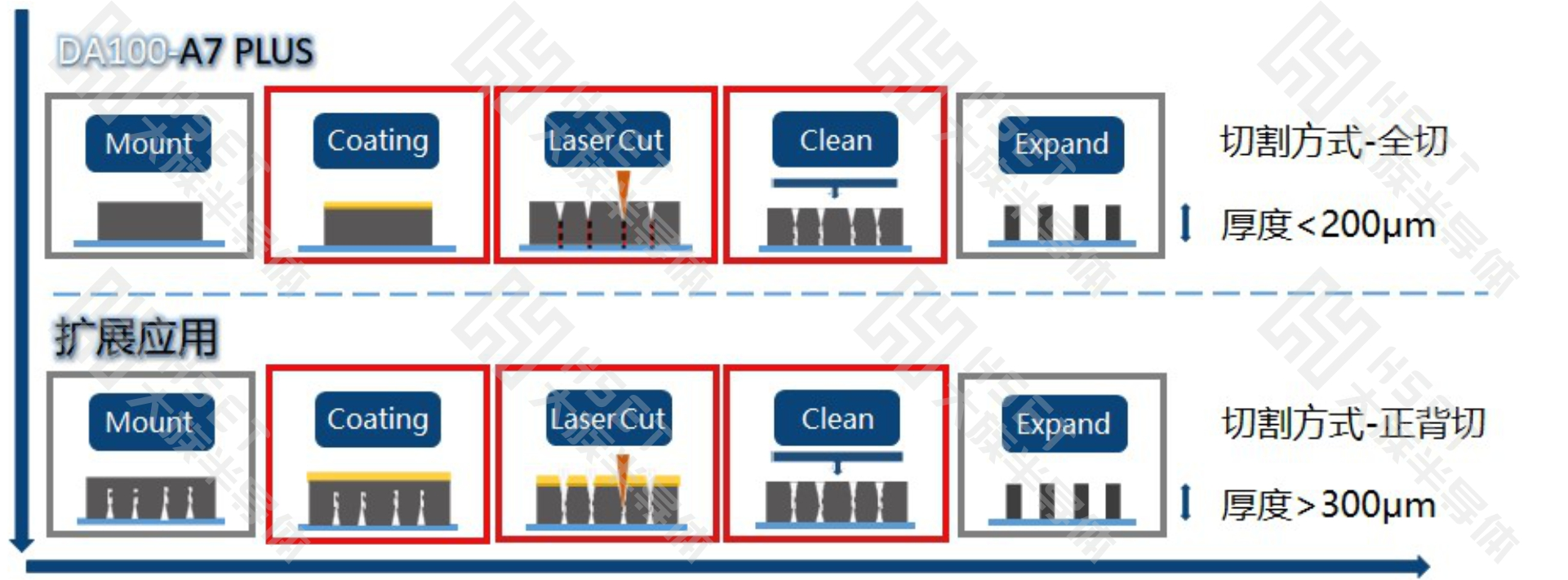
![]() 技術優勢
技術優勢
?涂覆品質
涂覆均勻,能解決切割道膠體沉積不完整,芯片上殘留氣泡等問題,切割清洗后無污染。

?修邊工藝
可將回熔高度清理至≤3μm,通過特殊工藝可將回溶高度清理至更低。


? 切割能力
可應對各種小尺寸晶粒切割需求(以100 μm thick GaAs產品切割效果為例)。
產品信息:
Wafer Size: 6’’
Wafer thickness:100μm thick GaAs
Street width:50μm
Street groove depth:15μm
Die pitch:180*180μm
Dicing width: 16±1μm
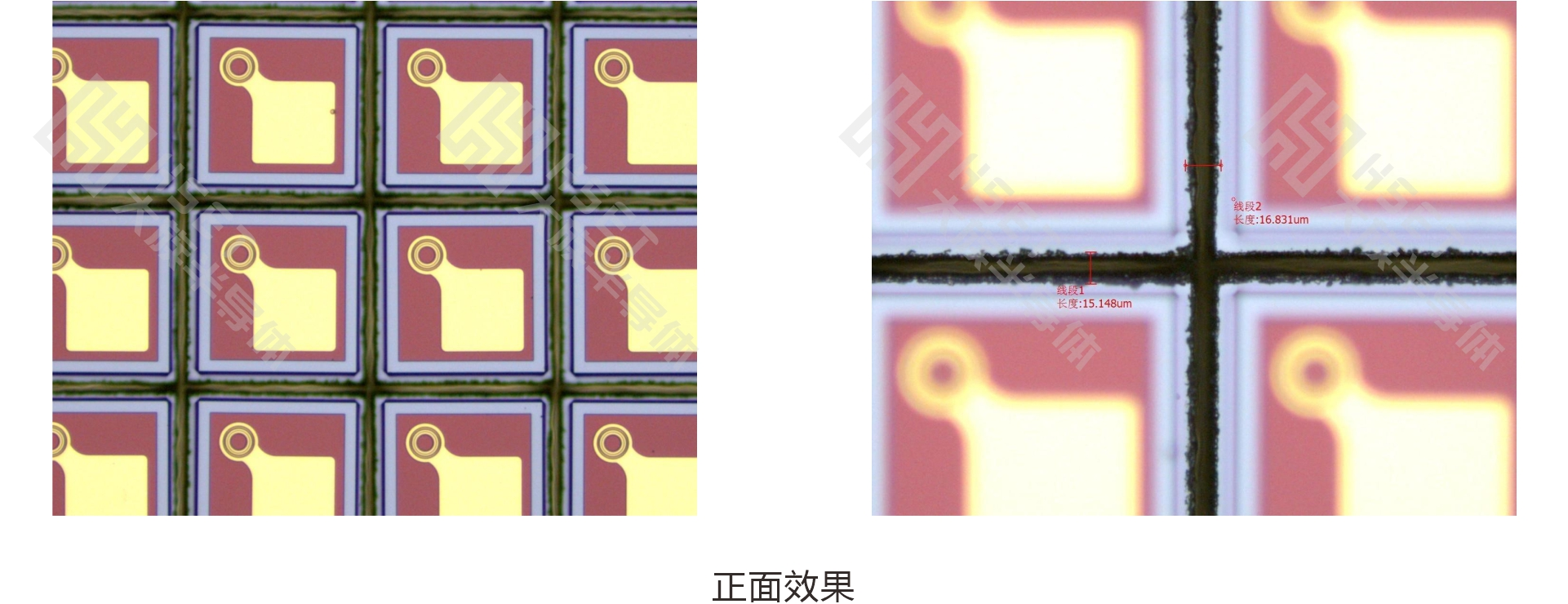
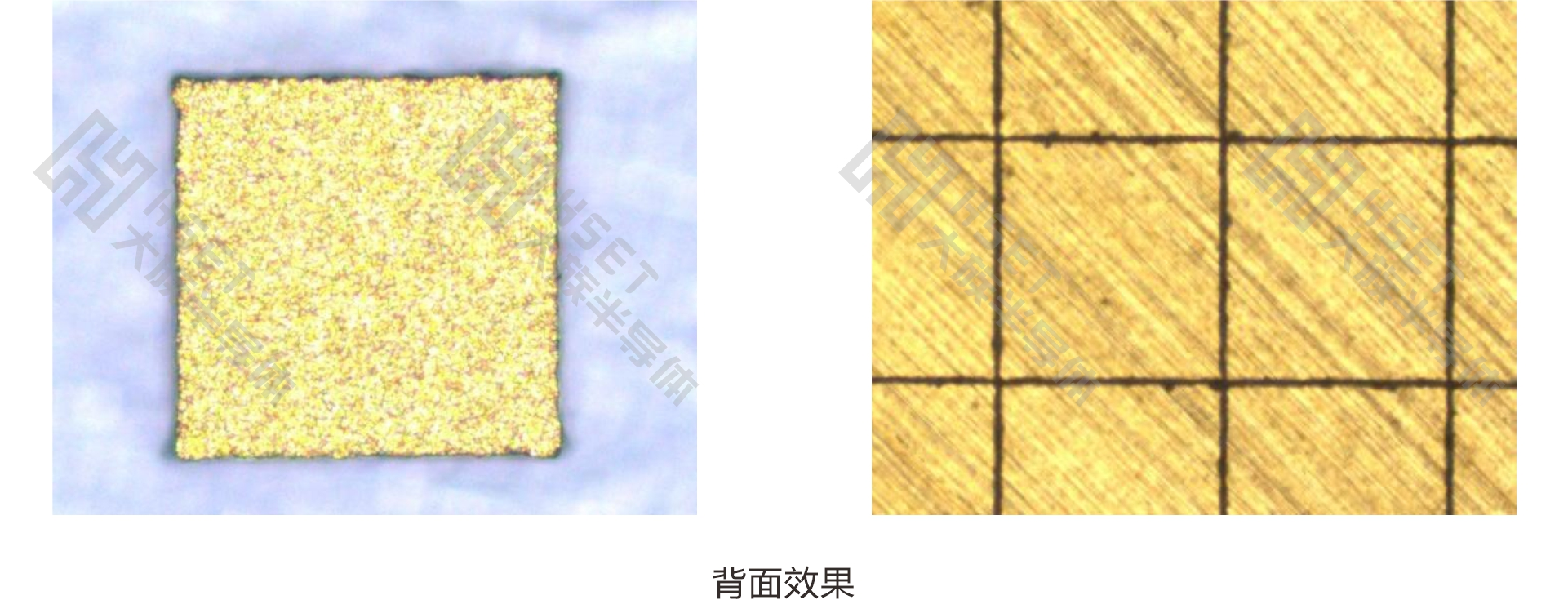
? 視覺系統
高清下CCD圖像系統優化后分辨率可達0.8μm/pix,可調焦;防止正背切錯位情況出現。
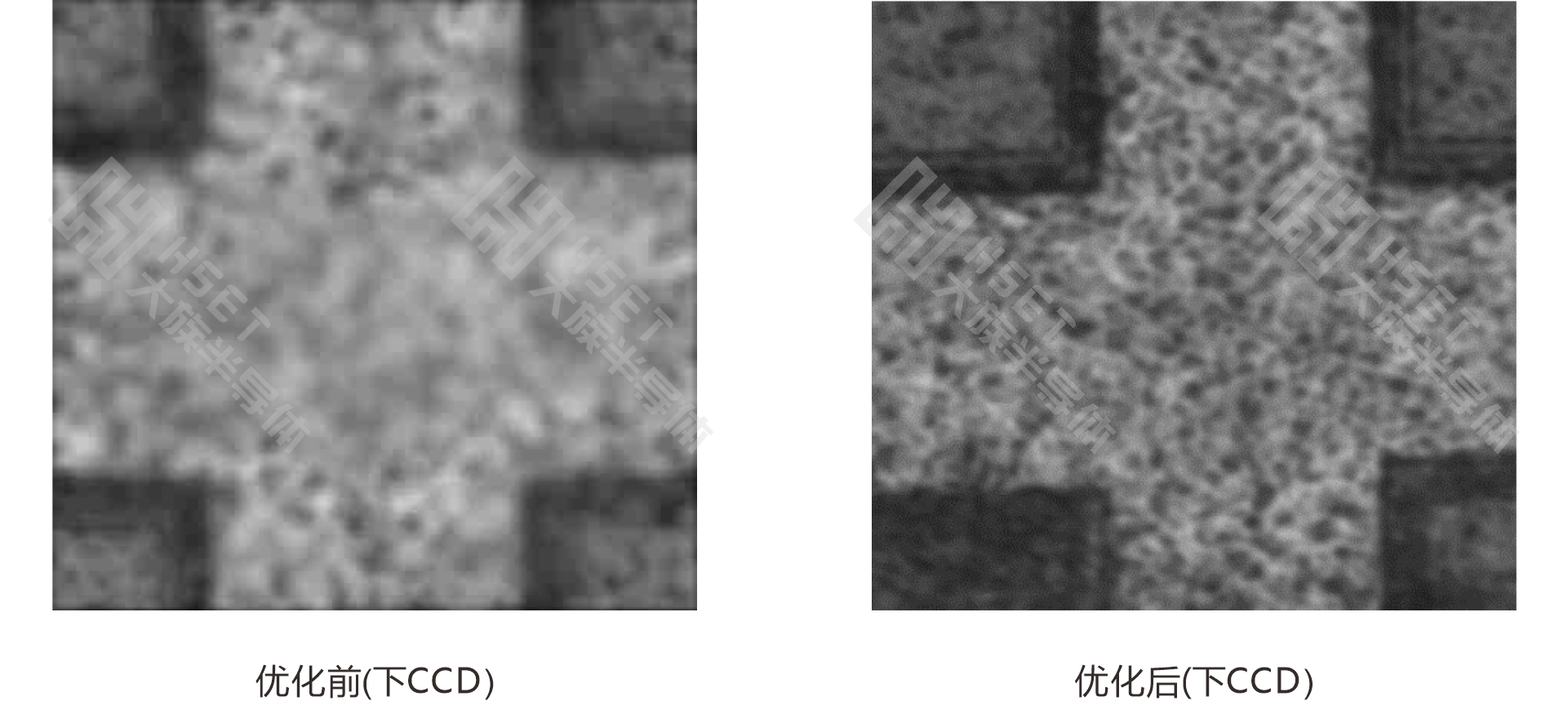
? SEMI認證
通過半導體設備SEMI認證評估(CE SEMI-S2),使用更安全。
? 粉塵處理
5層防護,層層過濾,可應對砷化鎵粉塵。
? 軟件功能
分區,輪次,多通道,多步距切割方式(可應對各種小尺寸晶粒)
MPW晶圓切割方法
殘片及多片切割模式
刀痕對位,切透檢測功能
多達12步定制化涂膠清洗程序
![]()
![]()
未來,隨著我國激光應用領域的擴展以及應用深度的加深,將對激光切割技術提出更高要求。大族半導體將持續以技術創新、工藝創新、產品創新為驅動,緊盯行業發展趨勢,滿足客戶專業切割需求,助推半導體行業激光應用技術的飛速發展。

