
由第三代半導體產業創新戰略聯盟舉辦的“第二屆第三代半導體材料及裝備發展研討會”于9月5日在北京召開。本屆大會為推進形成“材料、工藝、裝備一體化”的創新機制與發展,邀請了產業鏈上下游專家共同出席研討。大族顯視與半導體受邀出席并發表演講《激光技術在第三代半導體領域的應用》。
現階段以SiC、GaN為主的第三代半導體材料,因具備高頻高功率、耐高壓、耐高溫、抗輻射等性能,被廣泛應用于5G通訊、新能源汽車等領域;但同時由于SiC材料具有硬度高、生長成本昂貴、加工損耗大,GaN材料易于崩裂等特性,使得傳統機械加工方案在加工效果及生產成本上都無法滿足市場需求。為解決上述材料問題,大族顯視與半導體多年來不斷攻關,為第三代半導體材料的應用提供專業加工解決方案。

激光內部改質切割技術是通過將激光光束聚焦在材料的內部,在材料內部形成改質區域及裂紋區,以實現材料的切割。在加工過程中可抑制材料碎屑的產生,做到擴膜后無雙晶、切割直線度在5μm以內,崩邊小于10μm的效果,量產良率高達99.5%以上。除此以外,此技術還適用于氮化鎵、硅MEMS、鉭酸鋰、砷化鎵,藍寶石等多種材料。
大族顯視與半導體針對背金層的粘連、晶圓表面金屬或有機物鍍層的崩裂、切割道過窄而遮擋激光等不良現象,自主研發出專利技術并可提供有效的激光解決方案。
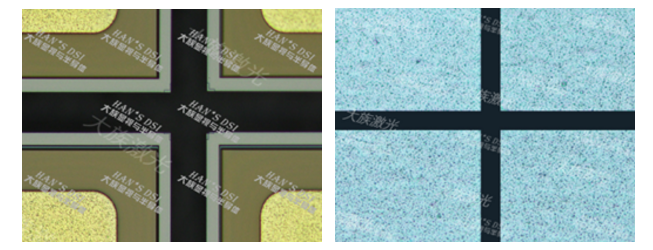
激光內部改質切割SiC晶圓
激光退火技術是利用激光瞬間高溫、熱傳導深度淺的特性,來實現SiC襯底與金屬層間的歐姆接觸。大族顯視與半導體SiC晶圓激光退火設備采用了自主研發光束整形技術,相比于普通光斑,光斑能量分布更均勻,能有效避免光斑中心能量過高而造成的材料局部損傷,僅需要較小的光斑重疊率,就可獲得均勻的退火效果,從而提高退火效率。
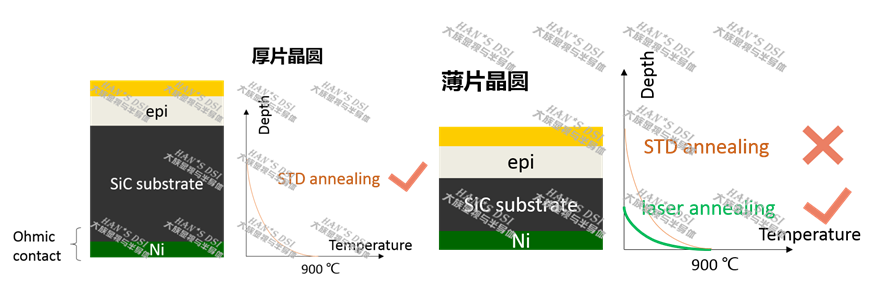
激光退火技術加工薄片SiC晶圓
設備可兼容4/6 Inch,支持超薄片退火,比電阻接觸≤10^-6Ωcm2,Process Chamber含氧量<10ppm,非退火面溫度<120攝氏度,采用模塊化設計,可擴展到其他材料工藝應用領域。該技術還可應用于注入離子后的晶格修復與雜質的激活活化,處理外延薄膜材料的結晶化。

激光退火前后的伏安特性曲線
傳統刀輪切割在對表面具有GaN/Low-K材料的半導體晶圓進行切割分片時,極易在GaN/Low-k層產生崩邊、卷翹和剝落等不良現象,而采用非接觸式的激光加工方案則可以有效避免上述問題。
大族顯視與半導體的激光開槽設備加工形成的形貌整體均勻、槽底十分平滑、粗糙度低于500nm,開槽側壁的熱影響區控制在3μm以內。

槽型良好 槽底平整 熱影響區小
在第三代半導體領域,大族顯視與半導體的多種激光技術始終走在國內前沿,除了上述解決方案,還可為第三代半導體產業鏈提供硅MEMS激光切割、全自動IC打標、激光解鍵合、刀輪切割、FT測試分選、TGV、IC卷盤封裝等技術方案。

據悉,國家計劃把大力支持發展第三代半導體產業寫入正在制定中的“十四五”計劃中。未來在利好的政策環境下,大族顯視與半導體結合雄厚的激光技術實力,聯合第三代半導體產業鏈上下游企業共同開發驗證,為第三代半導體產業提供創新的激光技術解決方案,努力實現國產化自給自足的目標!


